关于晶圆键合工艺的所有信息 物联网应用对传感器的要求包括:器件微型化、功能集成化 、低成本和海量制造。其中低成本和海量制造两者直接关联。由硅基集成电路制造技

VG 已在全球范围建立超过 1100 个EVG 晶圆键
2000x1678 - 680KB - JPEG

新型MEMS技术用于下一代光伏 - 控制工程网
308x237 - 13KB - JPEG

晶圆键合:选择合适的工艺来制造大功率垂直LE
420x366 - 36KB - JPEG
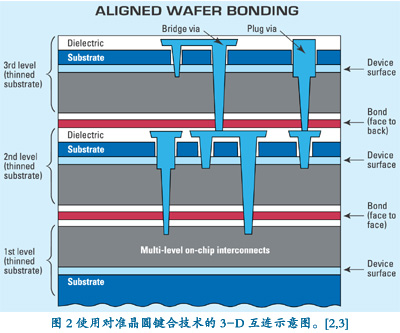
应用于3-D互连的对准晶圆键合技术[EDA\/IC设
400x333 - 51KB - JPEG

采用芯片粘结剂的晶圆背面涂覆工艺-电子行业
350x247 - 14KB - JPEG

超薄晶圆工艺用 临时键合装备系统 (涂胶+烘烤
872x582 - 75KB - JPEG

直接键合SOI晶圆的工艺
1280x1874 - 796KB - PNG

光刻和晶圆级键合技术在3D互连中的研究[测试
375x269 - 54KB - JPEG

微电子所在传感器晶圆级键合封装技术研究中取
531x284 - 25KB - JPEG

用于下一代3DIC的晶圆熔融键合技术.doc
993x1404 - 344KB - PNG
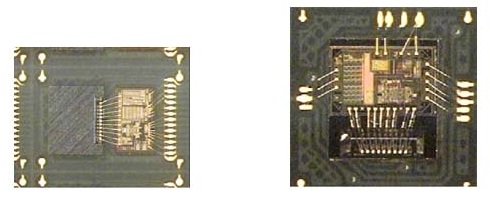
MEMS惯性传感器优势解析:THELMA制程和低
490x197 - 33KB - JPEG

新型MEMS技术用于下一代光伏_控制元件_工
351x287 - 15KB - JPEG

采用芯片粘结剂的晶圆背面涂覆工艺-电子行业
400x345 - 37KB - JPEG

采用芯片粘结剂的晶圆背面涂覆工艺-电子行业
300x281 - 23KB - JPEG

芯片-晶圆键合技术提高倒装芯片-晶圆键合产能
531x242 - 60KB - JPEG